随着先进制程厂商3nm技术商用化、AI芯片需求持续增长,以及先进移动处理器制程工艺不断演进,全球半导体制造进入了更高精密度的发展阶段。在先进制程的精密制造环境中,晶圆缺陷检测、EUV掩膜检测等关键环节,对成像系统的性能要求不断提升。TDI(Time Delay Integration)相机凭借其高速扫描、大幅面覆盖、高分辨率成像等技术优势,成为高端检测设备的核心组件。然而,在实际应用中,相机的检测精度很大程度上取决于一个技术细节——图像非均一性噪声校正精度。作为国内先进TDI相机技术提供商,鑫图光电在DSNU/PRNU校正技术方面积累了丰富的工程经验和技术优势。本文将深入解析DSNU/PRNU校正技术的物理机制、技术演进与应用实践,展示这一关键技术如何影响先进制程检测的最终效果。
1. DSNU 与 PRNU 概念解析
在理想模型中,图像传感器的每个像元(Pixel)在相同条件下应输出完全一致的信号值——这意味着其暗信号响应一致(无光条件)且光电响应一致(有光条件)。但现实中,由于像素制造工艺的微小差异、材料特性不均、工艺缺陷和读出电路的非理想行为,实际像元的响应存在个体差异,从而形成固定模式噪声(FPN)。
1)DSNU(暗信号不均一性)
DSNU(Dark Signal Non-Uniformity,中文:暗信号不均一性)指在完全无光条件下,不同像元的暗电流产生速率存在差异,导致输出信号存在固定的亮/暗偏差。这种噪声在长曝光、弱光成像时尤为突出,表现为背景中固定位置的亮点、暗点、竖纹或斑块结构。

图1-1:DSNU最典型的表现形式之一,清晰展示了像素暗信号不均一性的特点。
PRNU(Photo Response Non-Uniformity,中文:光响应不均一性)指在均匀光照下,不同像元对光的转换效率(量子效率或增益)存在差异,导致输出亮度存在固定的纹理或条带结构。其主要来源包括微透镜对准偏差、光电二极管面积差异、工艺掺杂不均等,表现为亮度纹理差异、条纹/带状噪声、网格/块状模式、渐变响应差异等。

图1-2:PRNU最典型的表现形式之一,清晰展示了像素光响应不均一性的特点。
2. DSNU 与 PRNU 校正技术解析
DSNU/PRNU 校正的核心,是消除图像传感器的“像素个性差异”,让所有像素表现如同一个理想像素,从而使系统捕获的仅是真实信号,而非传感器固有缺陷。经过校正,背景可接近理想的均匀灰,从而为定量检测提供更高的测量精度和数据可靠性。根据应用场景和需求不同,典型技术和发展方向主要包括以下几种:
1)人工/静态算法校正技术
通过暗场和均匀光场拍摄获得校正数据,补偿像素固有差异。该方式操作简便,适用于典型或标准化检测场景,但精准度会受到温度漂移、器件老化、光源光谱变化等动态因素影响。
2)制冷+温控校正技术
通过 TEC 制冷降低像素暗电流及 DSNU,并结合多组温度预存校正参数,实现温度漂移的适配。该方式能显著提升背景均一性和弱光信号纯净度,可将校正基线保持在稳定范围内,确保长时间运行的精度可靠性。
3)AI动态算法实时校正技术(未来发展方向)
利用 FPGA/ISP 实时采样,结合 AI 动态算法在线更新校正系数,实时响应光源波动、温漂和像素老化等复杂变化。该技术需要大数据支撑,是未来大规模、高通量、动态检测等高端系统的发展方向。
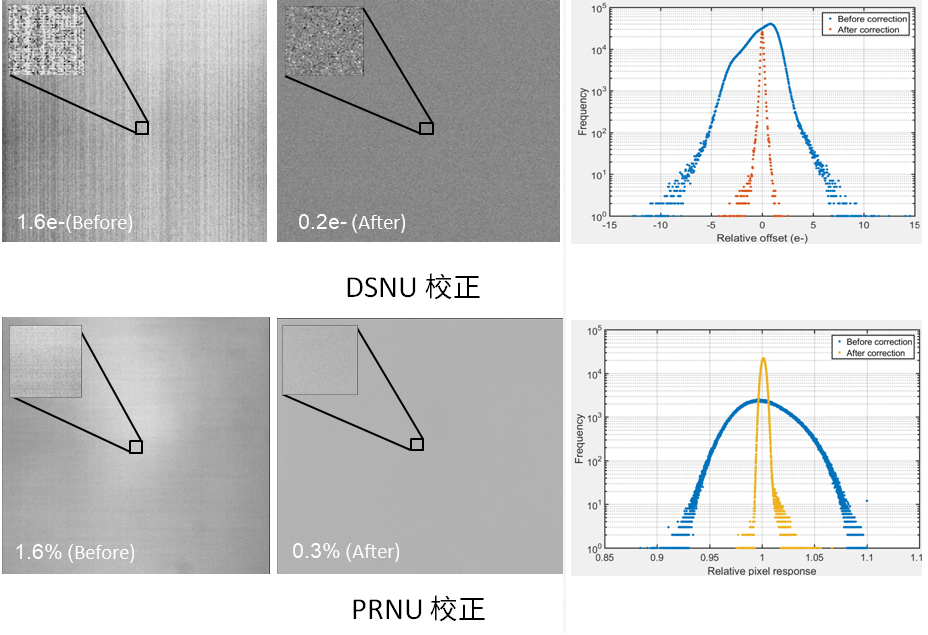
图2:DSNU/PRNU 校正前后效果对比。校正后图像背景呈现出高度均一性。
技术发展趋势:随着先进制程研发的持续推进,以及AI应用推动先进芯片需求增长,对检测精度的要求不断提升。校正技术正从传统的“事后补偿”、“过程抑制”向“实时校正”的智能化方向发展。
3. 半导体检测应用痛点解析
在先进制程的半导体检测中,背景均一性直接决定了低对比度缺陷的可检出率。无论是明场检测中仅比背景高出 1% 的细微反射差异,还是暗场检测中弱于背景几个数量级的散射信号,都要求 DSNU/PRNU 校正精度和稳定性达到更高标准。尤其在多波长、多角度、多行频等复杂检测模式下,任何校正残差都可能导致缺陷漏检或误检。
1)明场缺陷检测:信号与背景差异极小
应用痛点:在前道晶圆明场检测场景中,典型缺陷(纳米颗粒、光刻残留、微划痕)的反射信号,往往仅比背景高/低 1%~3%。当 PRNU 也在 1% 量级时,其“纹理噪声”会与缺陷信号强度相当,使低对比度缺陷直接淹没在背景中,就会造成漏检或误检。

图3-1:半导体DIC明场检测图像示例
2) 暗场/弱光缺陷检测:信号极其微弱
应用痛点:暗场检测依赖缺陷的散射光信号,其强度可能比背景低几个数量级。在这种条件下,DSNU 会在暗背景中形成固定亮模式,极易被算法误判为缺陷。

图3-2:半导体暗场缺陷检测图像示例
在半导体高 NA 检测系统或低光条件下,这种干扰被进一步放大。例如,在 PL/EL 检测中,缺陷信号可能仅有几十到几百 e⁻,而若 DSNU 残差达几十 e⁻,就足以淹没真实信号。
3)先进检测系统的挑战:多模式带来的复杂性
应用痛点:先进检测系统常需多波长、多角度、多行频等组合模式,但 PRNU 与 DSNU 在不同条件下的表现并不一致。如果补偿算法无法适应不同条件,就会在某些模式下出现缺陷检出率骤降的问题。

图3-3:半导体多条件检测系统应用痛点示意图
4. 鑫图先进DSNU/PRNU校正技术介绍
针对明场与暗场检测中低对比度信号易被背景噪声淹没,以及多波长、多角度、多行频模式下校正一致性难以维持的痛点,鑫图 TDI 相机通过高性能制冷温控系统与高精密参数校正等核心降噪技术,构建了全链路 DSNU/PRNU 噪声抑制体系,可实现半导体检测系统跨条件、长时间、低光照环境下的稳定高精度检测需求。
1)高性能制冷温控系统
·采用高效 TEC 制冷模块,大幅抑制像素暗电流并降低 DSNU 基线,显著提升弱光与暗场检测背景的纯净度。
·集成精密温控与反馈回路,实现 ±0.5℃ 温度稳定度,确保长时间运行中校正参数不漂移,满足纳米级先进制程的高稳定性要求。

图 4-1 :鑫图TDI相机制冷前后背景均一性对比
2)高精度参数校正功能
·支持数百组 TDI 校正参数存储与快速切换,针对多波长、多角度、多行频等复杂检测模式,逐一匹配最优校正表,避免条件切换导致的背景均一性下降。
·以 Gemini 8KTDI 相机为例,PRNU 可降至 0.124%、DSNU(10-bit)低至 5.8 e⁻,足以分辨低于 1% 对比度的微小缺陷信号。

图4-2:鑫图TDI相机软件PRNU/DSNU校正功能界面
5. 发展趋势与未来展望
在全球半导体产业向更先进制程迈进的征程中,DSNU/PRNU 校正技术已从辅助功能发展为核心技术。鑫图光电将持续投入研发资源,推动校正技术向更高精度、更智能化、更广应用的方向发展,为中国半导体制造业的自主可控和高质量发展提供有力支撑。
随着人工智能、物联网、自动驾驶等新兴领域对芯片性能要求的不断攀升,半导体检测的精度门槛也将持续抬高。唯有掌握底层核心技术原创能力的企业,才能在这场精密制造的竞赛中抢占先机,成为推动全球半导体技术进步的重要力量。
联系我们:如需获取鑫图 TDI 相机详细技术规格、应用案例或定制化解决方案,欢迎联系我们的技术团队。我们将为您提供从方案设计到产线集成的全流程技术支持。

 25/08/14
25/08/14



